半导体晶圆面型参数TTV、BOW、Warp是芯片制造必须要考虑的因素,十分重要。这三个参数共同反映了半导体晶圆的平面度和厚度均匀性,对于许多芯片制造过程中的关键步骤都有直接影响。
SiC硬度高、脆性大,切割难度大,在切片和减薄的过程中容易在晶片表面和亚表面产生翘曲等质量问题,影响后道工艺的开展,因此对Warp(翘曲)、BOW(弯曲)、TTV(总厚度偏差)等精度控制要求很高。

工信部《重点新材料首批次应用示范指导目录(2024 年版)》规定碳化硅单晶衬底(6 英寸及以上)标准:微管密度≤0.2/cm2,TTV≤10µm,BOW:-15~15µm,Warp≤35µm,表面粗糙度Ra≤0.15nm;N 型碳化硅衬底电阻率 0.015~0.025Ω·cm,BPD≤1000/cm2;半绝缘碳化硅衬底电阻率≥1010Ω·cm。

总厚度偏差——TTV(Total Thickness Variation)
晶片总厚度偏差TTV(Total Thickness Variation,总厚度变化)指晶圆在夹紧紧贴情况下,距离参考平面厚度的最大值和最小值的差值。一般以微米(μm)表示,一般表达形式如:TTV≤10µm。
TTV是晶圆减薄过程中的一项关键指标,它直接影响后续的各项封装工艺和芯片的最终质量。如果TTV值过大,可能会导致芯片性能不稳定、封装难度增加等问题,甚至可能使芯片失效。

弯曲度——BOW
Bow指晶圆在未紧贴状态下,晶圆中心点表面距离参考平面的最小值和最大值之间的偏差,偏差包括凹形和凸形的情况,凹形弯曲度为负值,凸形弯曲度为正值;一般以微米(μm)表示,一般表达形式如:-15~15µm。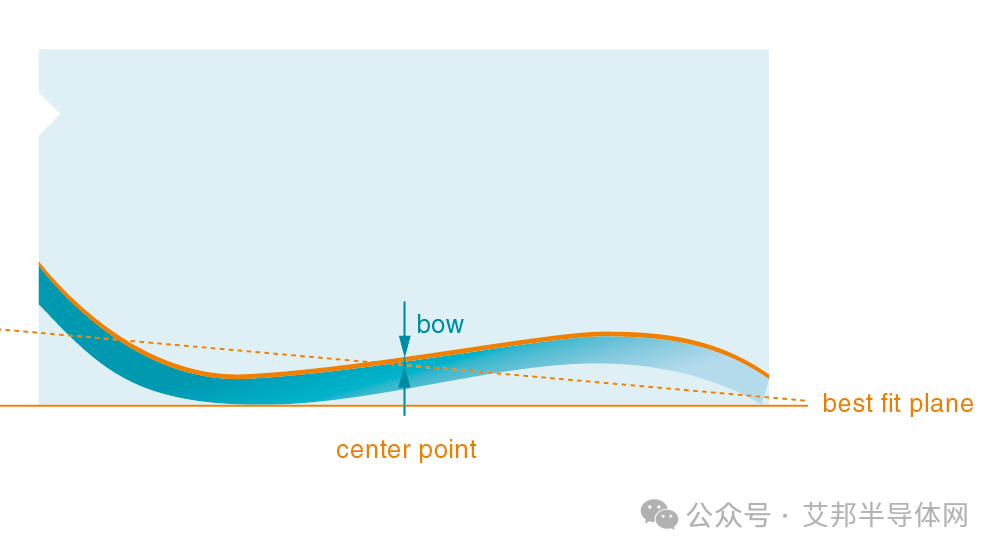
翘曲度——Warp
Warp是指晶圆的全局特性,晶圆在未紧贴状态下,通常以晶圆背面为参考平面,测量的晶圆表面距离参考平面的最小值和最大值之间的偏差,偏差包括凹形和凸形的情况,凹形弯曲度为负值,凸形弯曲度为正值;一般以微米(μm)表示,一般表达形式如:Warp≤35µm。
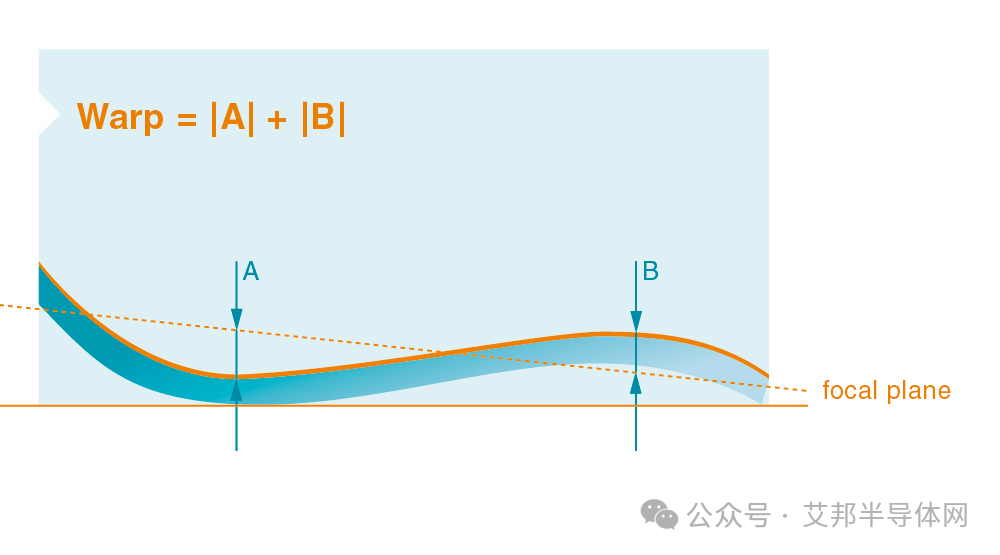
TTV、BOW、Warp的差别
Warp更全面,包括整个晶圆表面的弯曲和扭曲。
尽管这三个参数都与晶圆的形状和几何特性有关,但它们衡量和描述的方面各有不同,对半导体制程和晶圆处理的影响也有所区别。
TTV、BOW、Warp对半导体制程的影响
首先,这三个参数越小越好,TTV、BOW、Warp越大对于半导体制程的负面影响越大,因此如果三者的值超过标准,晶圆就要报废。
对光刻过程的影响:
焦深问题: 在光刻过程中,可能会导致焦点深度的变化,从而影响图案的清晰度。
对准问题: 可能会导致晶圆在对准过程中的偏移,进一步影响层与层之间的对准精度。
对化学机械抛光的影响:
抛光不均匀: 可能会导致CMP过程中的不均匀抛光,从而造成表面粗糙和残留应力。
对薄膜沉积的影响:
沉积不均匀: 凸凹的晶圆在沉积过程中可能会导致沉积薄膜厚度的不均匀。
对晶圆装载的影响:
装载问题: 凸凹的晶圆可能在自动装载过程中导致晶圆损坏。
碳化硅衬底加工过程中,除了改善切割工艺外,一般还会在切割时会留有余量,以便在后续研磨抛光过程中减小TTV、BOW、Warp的数值。
-END-
原文始发于微信公众号(艾邦半导体网):碳化硅晶圆减薄工艺中的重要指标


