功率器件的封装正朝着小体积和3D封装发展,在工作损耗不变的情况下,使得器件的发热功率密度变得更大,在热导率和热阻相同的情况下,会使得封装体和裸芯的温度更高,高温会带来许多问题。
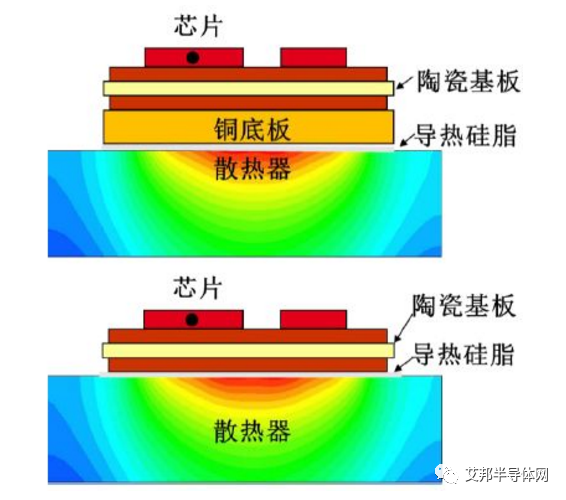
图 有铜底板和无铜底板模块结构及散热路径
(1)热-电效应
高温使得半导体器件的性能下降,如通态电阻增大、导通压降增加、电流上升变缓等。
(2)热-机械效应
高温使得物体发生明显膨胀,由于不同材料的热膨胀系数不同,不匹配的膨胀系数会使得封装内部各部分之间产生热应力,严重时会产生变形甚至破裂。
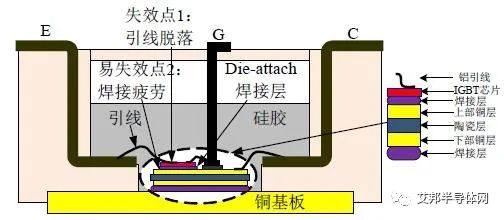
图 IGBT模块失效机理
(3)热-分子效应
高温使得键合、焊接部位的强度降低,影响接触性能。
(4)热-化学性能
裸露的金属(引脚、焊盘等)在高温下更容易受到外界的腐蚀。
为了使得器件在体积和热性能发面得到兼顾,除了继续减小器件的导通阻抗,还有两种思路。
第一种是加快热量从裸芯-封装体-热沉的传递速度以及封装器件对外的热传递,即增加热导率,减小热阻;
另一种是减小高温对器件各部分的影响,即分析热效应。
减小热阻不仅是单片封装需要考虑的问题,也是模块封装的基础;而从热效应出发,往往需要对研制和工艺提出很高的要求,因此从热阻出发进行热设计效率更高。
迄今为止,功率模块主要采用平面封装结构,内部互连技术多采用引线键合技术。芯片在切换过程中会产生损耗,损耗转换成热量,通过封装模块材料扩散到周围环境中。随着IGBT器件功率密度的增大,散热性能是非常关键的问题。IGBT堆叠结构不但可以提高功率密度,还有效地解决了整个模块的散热性能。陶瓷基板与衬底直接相连,快速的将热量传递到周围环境中。
来源:海飞乐技术
原文始发于微信公众号(艾邦半导体网):IGBT功率模块封装主要面临哪些问题?


