
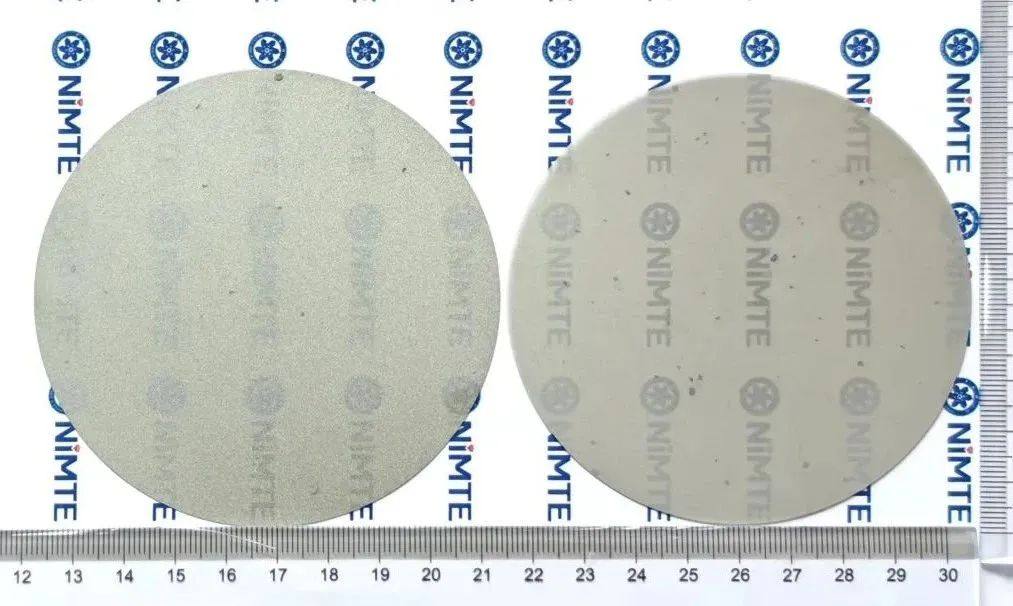
超低翘曲金刚石自支撑薄膜实物拍摄(正面)
金刚石凭借其超高热导率成为解决高频大功率芯片散热难题的关键材料。将硅(Si)、氮化镓(GaN)、碳化硅(SiC)等芯片直接键合到金刚石薄膜上,可大幅降低近结热阻和芯片结温,是未来高性能芯片及3D芯片封装热管理的理想方案。金刚石薄膜通常是在衬底上形核生长,然而,受限于现有工艺,薄膜与衬底之间以及薄膜内部存在较大应力,导致去除衬底后发生显著翘曲,难以满足键合工艺的翘曲度要求,成为制约其封装应用的核心瓶颈。
针对这一挑战,中国科学院宁波材料技术与工程研究所江南研究员领导的功能碳素材料团队通过创新技术,成功制备出4英寸、厚度小于100 μm的金刚石自支撑薄膜。该自支撑薄膜在4英寸范围内翘曲度小于10 μm;贴附于玻璃基板时形成自吸附,充分展现了其超高平整度和低应力特性。该类型金刚石自支薄膜的成功研制,为克服长期制约芯片键合制程的翘曲难题,推动金刚石在热管理领域的发展迈出了关键一步。
感 谢 悦 读
来源|海洋关键材料全国重点实验室 王跃忠
编辑|材华君

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入交流群。





