2026年04月27日,京瓷株式会社正致力于推动多层陶瓷基板的商业化开发。此类基板作为先进半导体封装的核心基材,主要面向 xPU 和交换机 ASIC 等器件封装需求;随着 AI 数据中心技术的日益精密化,此类封装器件的尺寸正呈现不断增大的趋势。该基板通过采用可实现高密度布线且具有优异基板刚性的独特陶瓷材料,能够减少先进半导体封装安装时的翘曲。
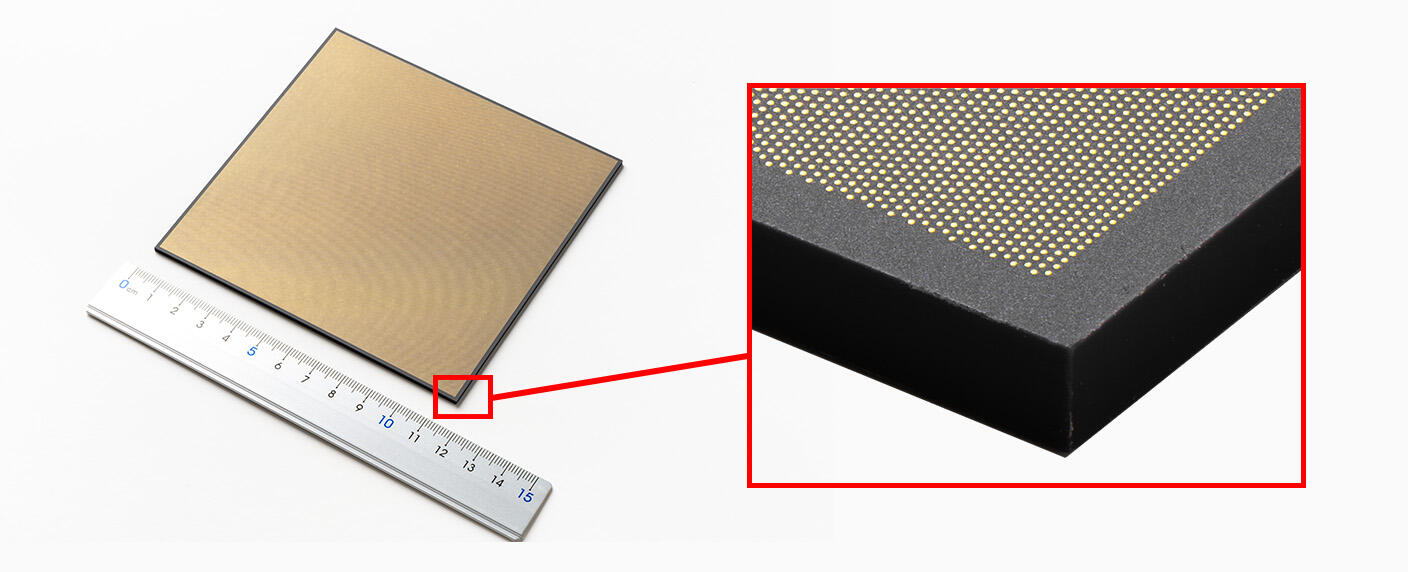
图 正在研发的用于先进半导体封装的多层陶瓷基板
(通孔直径:75 µm,通孔间距:200 µm)
近年来,随着生成式AI及大语言模型的普及,全球范围内数据中心的建设与扩建正呈加速态势。为支撑这一增长需求,xPU 和交换机 ASIC 等先进半导体器件为实现高速大容量通信而不断向高性能化方向发展,加速了封装基板的大型化和高密度布线化,尤其是2.5D封装领域。然而,在有机基板方面,随着尺寸增大导致的刚性不足而引起的翘曲问题以及芯材上的线路微细化技术仍面临挑战。为解决这些问题,京瓷将充分发挥在多层陶瓷封装领域积累的材料与芯材技术,致力于开发兼具高刚性和微细布线能力、并可形成积层结构的多层陶瓷芯板。
多层陶瓷基板主要特性:
1. 采用高刚性多层陶瓷基板,具有更高的刚性和弯曲强度,有效缓解封装基板翘曲,此外,由于即使板厚较薄也能获得同等的效果,因此也有助于封装基板的薄型化。

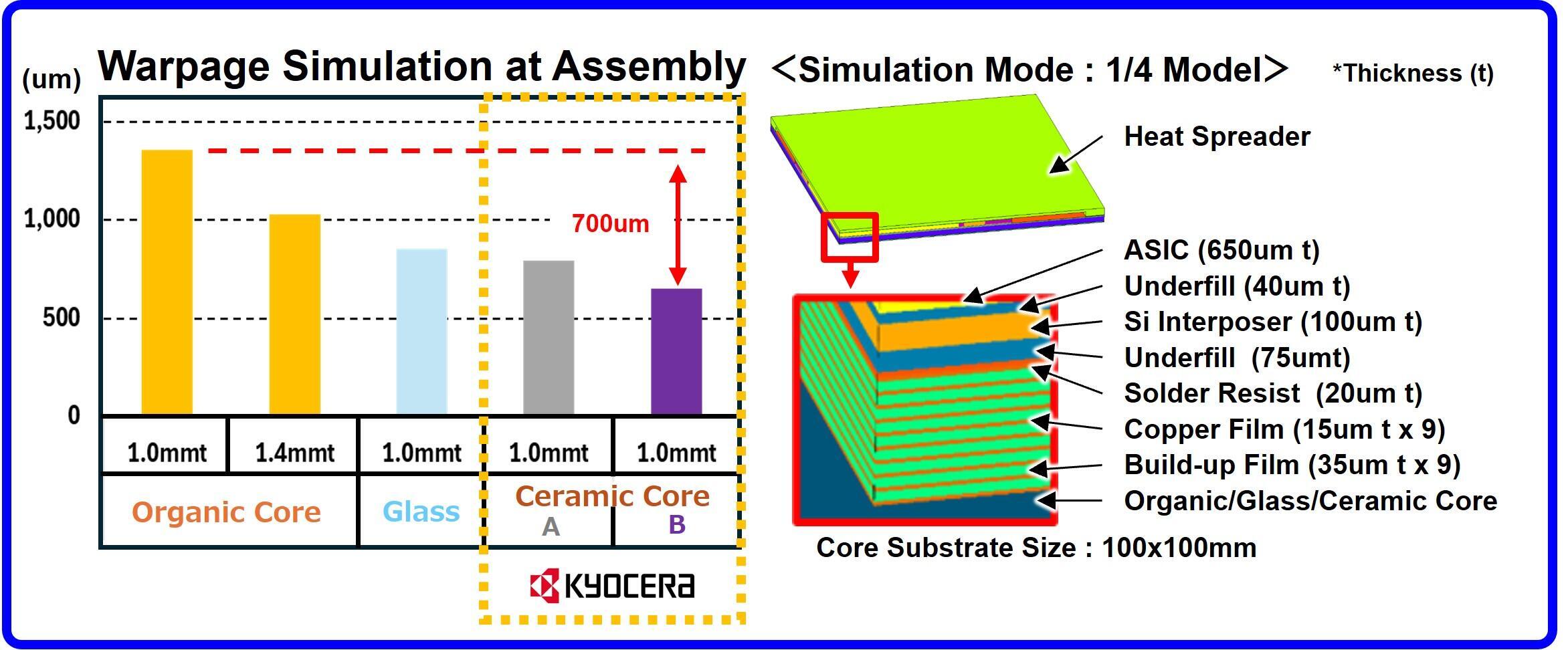
图 2.5D 封装后的翘曲与仿真模型对比
2. 借助多层陶瓷制造工艺,实现了基板互连结构的微型化。在陶瓷基板中,用于电气连接基板正反两面之间厚度方向的导体被称为“导通孔”。这种导通孔的形成,是在陶瓷材料经过烧成变硬之前的柔软状态下,通过特定的制造工艺完成。因此,与有机基板的导通孔加工工艺中采用的钻孔加工等相比,陶瓷工艺具有更优异的微细加工性,从而能够实现传统有机基板在高密度布线方面所面临的导通孔小径化与窄间距化的难题。
3. 支持各类仿真分析,并具备定制设计能力。
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入交流群。



