本文主要根据业界知名回流炉厂家Heller与业界铟片头名生产商Indium 公司在2022年第72次ECTC会议上联合发表的一篇文章《 Optimizing Reflowed Solder TIM (sTIMs) Processes for Emerging Heterogeneous Integrated Packages》为基础,聊聊铟回流焊。
铟金属可能很多朋友还不太了解,铟的热传导率可达86W/(m*K),而普通的导热膏 仅为5~10 W/(m*K)。另外,铟是一种银白色软金属,可塑性强,有延展性,可压成片,如果接触面两侧有一定的压力,能够很好地把铟夹在中间,那么散热效能更好。铟片特有的散热方式,使其经常应用在芯片的封装结构中。几十年来,铟金属一直是大多数高性能计算(HPC)中焊接热界面材料(焊接TIMs或sTIMs)的标准用料。IEEE异构集成热路线图指出,新的热界面材料解决方案必须提供一条成功应用的途径,以满足总封装DIE面积达到100c㎡的产品,未来两年需要解决高达1000W/c㎡的热通量问题。图1显示7nm与其之前制程相比热通量明显上升。

铟及其合金都被用作回流焊料热界面材料置于芯粒表面与散热盖之间。图2显示标准的如何将高性能芯片热量带走的产品结构图。TIM1,TIM2等是不同的型号。最上面的是散热片,然后是铟材料层,接着是Lid散热盖同时具有非常好的力学性能可以保护芯片不被损坏,然后再是通过铟材料将散热盖与芯片表面连接。

图2 标准的从如何将高性能芯片热量带走的产品结构图
如图3所示,整个TIM封装工艺流程为:第一步,在基板上芯片周围涂覆密封材料;第二步,在DIE上面喷涂助焊剂层;第三步,贴附TIM材料;第四步,继续在TIM材料上喷涂助焊剂;第五步,将Lid散热盖置于上方,并保证与TIM材料良好接触;最后一步,通过加热回流将所有焊接在一起。
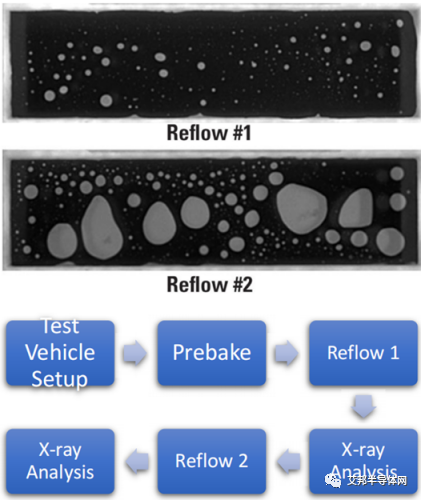
在整个回流工艺中最容易产生的缺陷有void空洞、分层以及其它界面相关问题。如图4所示。
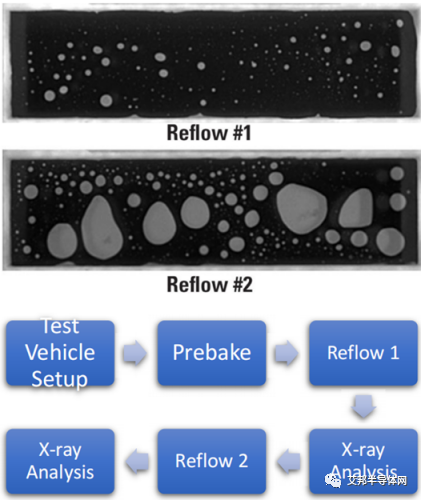
图4 左图为CSAM下TIM的图案,有明显分相,空洞等缺陷;右图为正常的CSAM图像
助焊剂的喷涂只要是为了去除氧化层,这里不再赘述。接着聊聊空洞Void的产生机理。Void产生和控制有两大方向:一.改变材料或材料的用量;二.优化回流焊工艺;第一个非常容易理解,尽量减少回流焊时气体产生的量,或调节空洞产生的速度,如表1所示。第二个方向较为容易实现,调升温曲线快速简便。如图5可以看出同样TIM在二次回流后空洞明显变大。这说明气体在第一次回流时并没有完全释放出来,这种情形就比较危险。因为二次回流通常会在SMT等环节进行,不容易被前端封装工艺中发现异常。
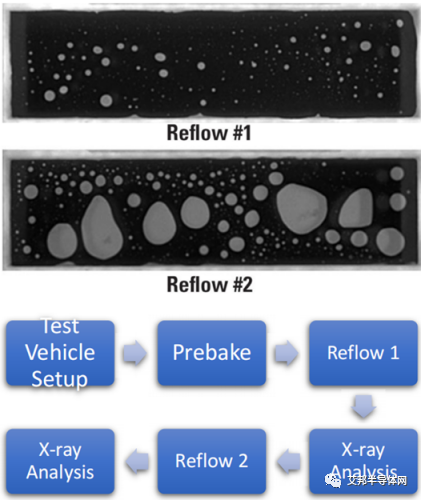
表1 为不同合金成分同样工艺条件下产生的空洞Void比例
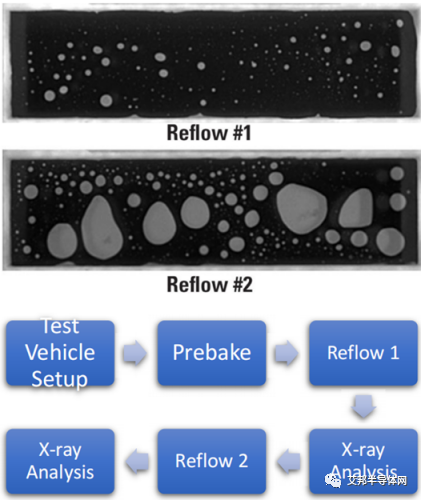
图5 第一次Reflow后和第二次Reflow后空洞大小区别
这时候该另外一个巨头Heller出场了,Heller是回流焊炉子的专业生产商之一。就如我们艾邦半导体公众号近期介绍的Heller无助焊剂甲酸炉工艺,Heller也在TIM领域尝试了他们的甲酸炉,并通过增加真空度来控制Void的产生。从表2看出,通过真空度的增加Void的比例明显下降。

表2 通过不同真空及甲酸浓度下使用Heller设备回流所产生Void的比例
该团队也尝试了通过在回流时增加压力来控制Void比例,如表3所示,整体与真空回流相比效果不佳。
表3 通过在回流时增加不同压力所产生Void的比例
最后,TIM铟材料的制备当前业界还属Indium公司,国内的厂家有宁波施捷电子有限公司。在设备厂家中屹立芯创真空压力除泡系统也有很大突破。如果您还清楚其它材料及设备供应商也请入群告知我们。谢谢。
参考文献:
1. https://www.sohu.com/a/629170467_121628353
原文始发于微信公众号(艾邦半导体网):先进封装之铟片回流焊介绍