核心导读
在新一代电子信息技术浪潮的推动下,电子电路基材向高频化、高速化发展。开发无粗化(或低粗化)铜面的处理工艺,是目前在面向5G通讯技术的高频高速电子电路制造中亟需解决的新课题,低粗糙度、强结合力、高可靠性必然是其研究和未来产业化方向。光华科技开发的键合剂SF-2002采用"微粗化+键合剂"的组合模式,能有效减少信号插入损耗,提升电性能收益,可靠性达到传统棕化产品的水平,取得终端客户认证。目前已经在5G通信行业领导品牌M客户和国内中高端印制电路板领先品牌W客户上线作批量测试,客户反馈良好,性能优于原有的产品。面对发展迅猛的5G甚至6G技术,多层板压合前处理制程中,铜表面粗糙度要求进一步降低,光华科技在该领域仍在深入研究,向下一代"纳米粗化"到"无粗化"技术不断创新前进,为客户创造价值。
目 录
1、5G对材料及表面处理的新要求
2、键合剂SF-Bond 2002工艺流程介绍
3、键合剂SF-Bond 2002性能表现
4、总结与展望
1、5G对材料及表面处理的新要求
随着新一代电子信息技术(5G)的迅速发展,超快速度的信息处理和超高容量的信息传输需求迫使电子电路基材(主要为覆铜板)向高频化、高速化发展。高频信号的高速传输,会产生信号损耗,并且频率越高,损耗越大。众所周知,信号传输整体损耗主要包括介质损耗和导体损耗,具体影响因素如图1所示:
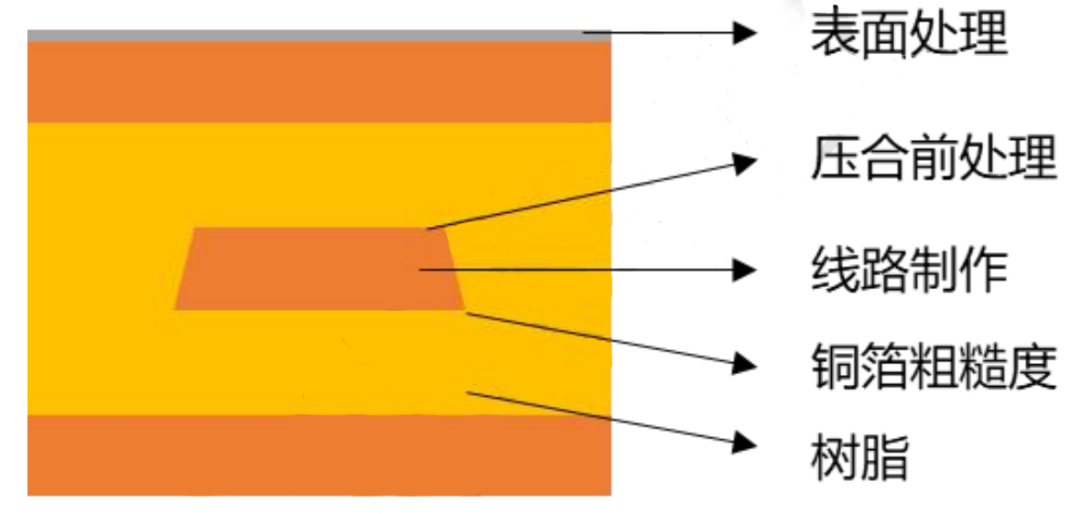
▲图1 PCB信号传输的影响因素
为应对这一挑战,一方面,可以采用low Dk和low Df的树脂减少介质损耗;另一方面,通过使用超低轮廓(HVLP)的铜箔减少导体损耗。但随着传输频率的升高,由于趋肤效应,表界面粗糙度会对高频高速信号造成损耗,尤其是在毫米波段(30-300 GHz),表面粗糙度对信号传输影响非常大[1-4],如图2所示。

▲图2 铜的趋肤深度计算
因此,开发无粗化(或低粗化)铜面的处理工艺,是目前在面向5G通讯技术的高频高速电子电路制造中亟需解决的新课题[5],低粗糙度、强结合力、高可靠性必然是其研究和未来产业化方向。但低粗糙度和强结合力、高可靠性是相互矛盾的。为解决此问题,一个有效的方法是在低粗糙度铜面处理后,通过引入有机键合剂[6],利用其化学作用力和微粗化的机械互锁共同作用,取代传统粗化的机械嵌锁作用,满足面向5G高频高速覆铜板的低信号插损、强结合力和高可靠性要求。
光华科技的键合剂SF-Bond 2002正是基于以上理念开发的低粗糙度压合前处理药水,用于高频高速领域高多层板压合前处理,目标是取代传统的棕化处理工艺。
2、键合剂SF-Bond 2002工艺流程
 3、键合剂SF-Bond 2002性能表现
3、键合剂SF-Bond 2002性能表现
(1).低微蚀量——全流程微蚀量为0.50-0.80µm,对线宽基本无影响,对于精细线路控制极为有利。
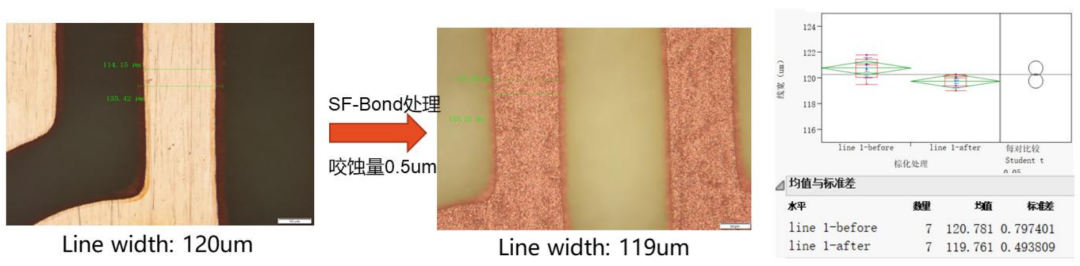
(2).低粗糙度——全流程处理后,表面粗糙度Rz<1.50µm,比表面积Sdr<115%,远远优于业界现用低粗糙度棕化药水。
①.不同板材和铜箔键合处理前后的粗粗糙度、比表面积对比:
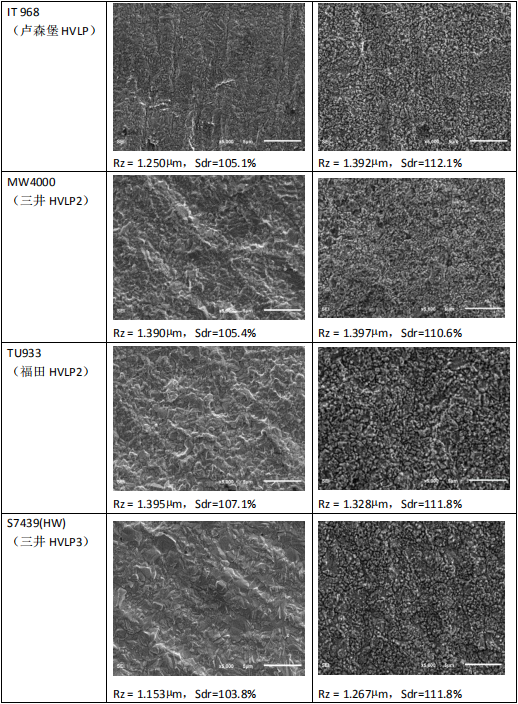
②.键合剂SF-Bond 2002与其他低粗糙度棕化药水对比——M7GE材料(南亚HVLP2铜箔)。
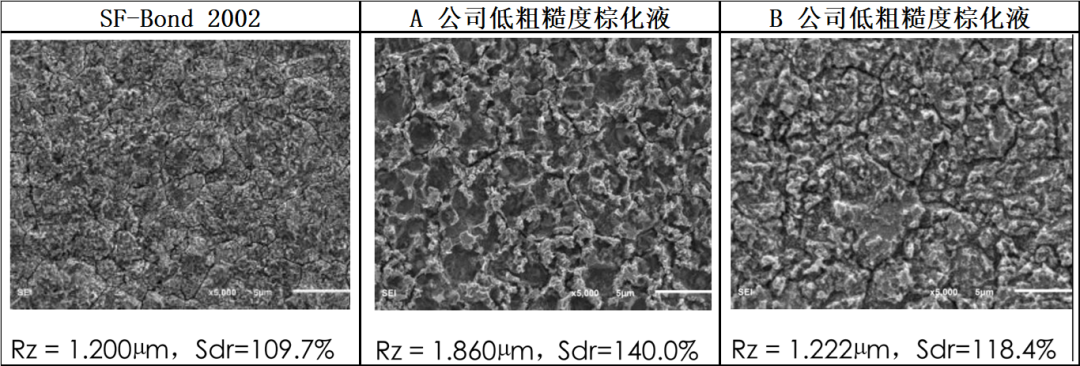
(3).电性能收益——信号衰减水平远远优于传统棕化液和现用低粗糙度棕化液,达到终端客户的验收标准。
①.与普通棕化对比——SF-Bond 2002相比普通棕化药水有优异的电性能收益;而且对于Low Loss等级材料,SF-Bond 2002带来的电性能收益与升级材料相当,但成本却大大降低。
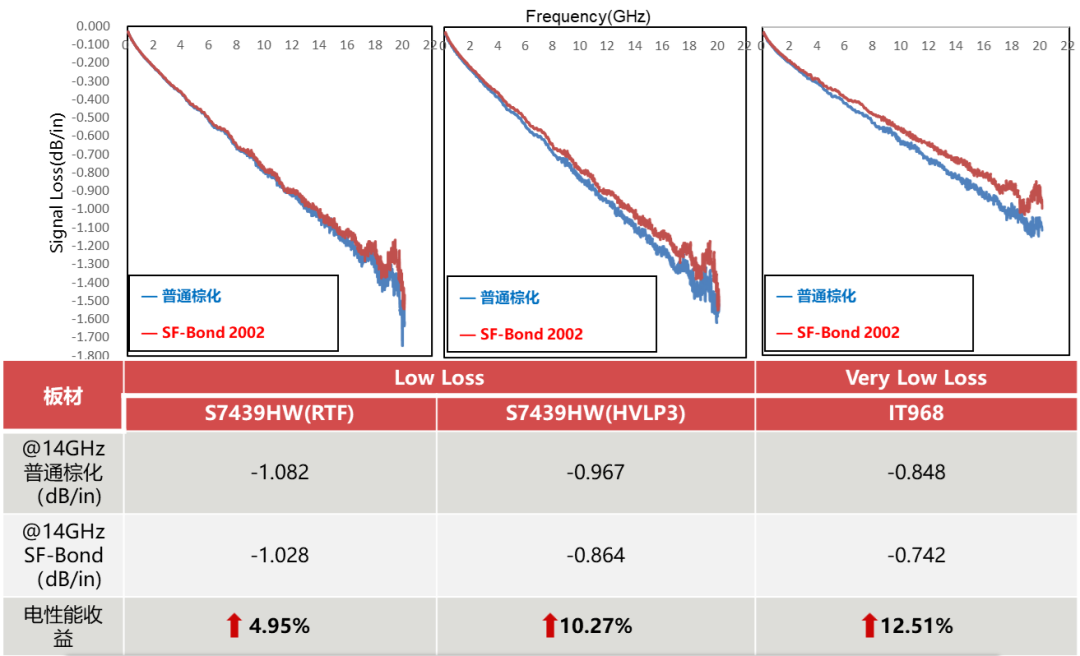
②.与A公司低粗糙度药水对比——对于M7级别以上的材料,电性能提升约3%(@14GHz),达到终端客户的验收要求。
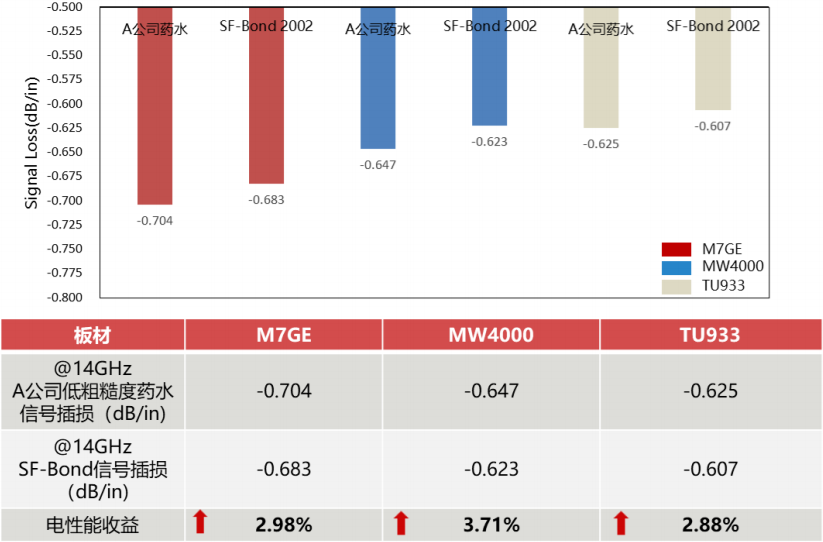
(4).剥离强度——键合剂SF-Bond 2002搭配多种高速材料,经过260℃ IR Reflow 5次后剥离强度保持稳定;对于M7以上级别的材料,剥离强度优于现用低粗糙度棕化药水。


(5).高多层板可靠性测试——28层板,过5次IR后BGA位置和散热孔没有出现裂纹、分层的现象,可靠性达到要求。
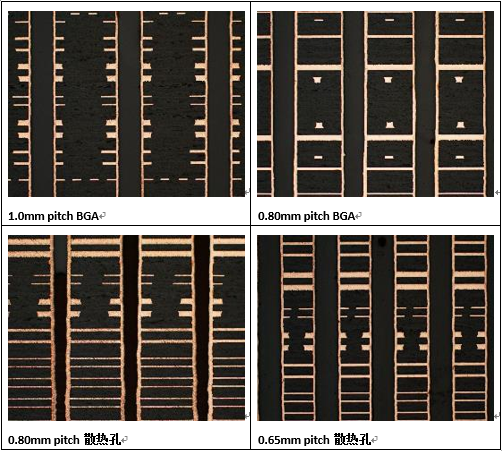
(6).长期可靠性测试——28层板,长期可靠性合格,达到终端客户的验收标准。

4、总结与展望
光华科技开发的键合剂SF-2002采用"微粗化+键合剂"的组合模式,能有效减少信号插入损耗,提升电性能收益,可靠性达到传统棕化产品的水平,取得终端客户认证。目前已经在5G通信行业领导品牌M客户和国内中高端印制电路板领先品牌W客户上线作批量测试,客户反馈良好,性能优于原有的产品。
面对发展迅猛的5G甚至6G技术,多层板压合前处理制程中,铜表面粗糙度要求进一步降低,光华科技在该领域仍在深入研究,向下一代"纳米粗化"到"无粗化"技术不断创新前进,为客户创造价值。
参考文献:
[1] 毛英捷. 印制电路铜面粗化效果对信号完整性的影响研究[D]. 成都:电子科技大学, 2017.
[2] 文娜. 高频印制电路铜面平整化修饰技术及工艺研究[D]. 成都:电子科技大学, 2017.
[3] 余振中. 铜箔粗糙度对高速材料信号损耗影响分析[J]. 覆铜板资讯, 2016, 2:30-38.
[4] 林金堵. 信号传输高频化和高速数字化对 PCB 的挑战(1)——对导线表面微粗糙度的 要求[J]. 印制电路信息, 2008, 10:15-18.
[5] T. Devahif, C. Foil, W. Luxembourg. Ultra Low Profile Copper Foil for Very Low Loss Material[J]. Proceedings of SMTA International, 2016, 888-893.
[6] 三浦昌三, 村井孝行, 奥村尚登, 谷冈宫, 胜村真人, 山地范明. 唑硅烷化合物、表面 处理液、表面处理方法及其利用[P]. 中国: CN105358563B, 2018.03.30.


