精密划片机主要用于硅片、陶瓷、玻璃、砷化镓等材料的加工,也被广泛应用于集成电路(IC)、陶瓷薄板、PCB、蓝宝石玻璃等行业。划片机作为半导体芯片后道工序的封装环节加工设备之一,用于晶圆的划片、分割或开槽等微细加工,其切割的质量与效率直接影响到芯片的封装质量和生产成本。例如用于LED晶片的分割,形成LED芯粒。

半导体晶圆划片机主要用于封装环节,是将含有很多芯片的wafer晶圆分割成一个一个晶片颗粒的设备,目前行业主要以机械划片为主,包括主轴、控制系统等,由于切割基体为半导体器件,所以产品良率及控制要求较高。
划片机目前以砂轮机械切割为主流切割方式,激光是重要补充。划片机主要包括砂轮划片机和激光划片机:(1)砂轮划片机是综合了水气电、空气静压高速主轴、精密机械传动、传感器及自动化控制等技术的精密数控设备,在国内也称为精密砂轮切割机。(2)激光划片机是利用高能激光束照射在工件表面,使被照射区域局部熔化、气化、从而达到划片的目的。
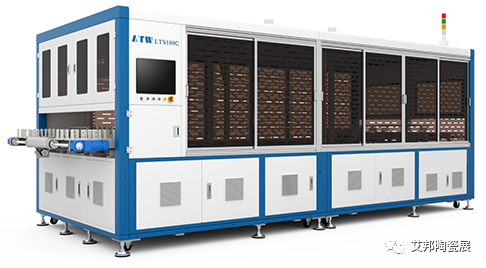
目前市场以砂轮切割机为主,主要是激光切割不能使用大功率以免产生热影响区(HAZ)破坏芯片;激光切割设备非常昂贵(一般在100万美元/台以上);激光切割不能做到一次切透(因为HAZ问题),因而第二次切割还是用划片刀来最终完成。
VLSI数据显示划片机在封装设备的价值量为28%,根据SEMI数据,2021年全球封装设备市场规模为69.9亿美元,2021年全球封装设备市场规模为69.9亿美元,对应2022年划片机的市场空间约为20.4亿美元。
从格局看国外供应商如日本DISCO、东京精密、以色列ADT等垄断。目前日本Disco垄断了全球70%以上的封装关键设备减薄机和划片机市场,东京精密ACCRETECH次之,划片机国产化率仅5%左右,国内主要企业有光力科技、中电科45所、江苏京创、沈阳和研以及深圳华腾等。
原文始发于微信公众号(艾邦陶瓷展):晶圆划片机——封装工序的超精密设备