陶瓷覆铜板既具有陶瓷的高导热性、高电绝缘性、高机械强度、低膨胀等特性,又具有无氧铜金属的高导电性和优异的焊接性能,并能像PCB线路板一样刻蚀出各种图形。

陶瓷覆铜板具有陶瓷部分导热耐压特性;铜导体部分具有极高的载流能力;便于刻蚀图形,形成电路基板;焊接性能优良,适用于铝丝键合。
陶瓷基板材料的性能是陶瓷覆铜板性能的决定因素。目前,已应用作为陶瓷覆铜板基板材料主要有氧化铝、氮化铝和氮化硅陶瓷基板。氧化铝基陶瓷基板是最常用的陶瓷基板,由于它具有好的绝缘性、好的化学稳定性、好的力学性能和低的价格,但由于氧化铝陶瓷基片相对低的热导率、与硅的热膨胀系数匹配不好。作为高功率模块封装材料,氧化铝材料的应用前景不容乐观。
氮化铝陶瓷覆铜板既具有陶瓷的高导热性、高电绝缘性、高机械强度、低膨胀等特性,又具有无氧铜的高导电性和优异的焊接性能,是IGBT模块封装的关键基础材料。整个模块内部应力较低,提高了高压IGBT模块的可靠性。这些优异的性能都使得氮化铝覆铜板成为高压IGBT模块封装的首选。
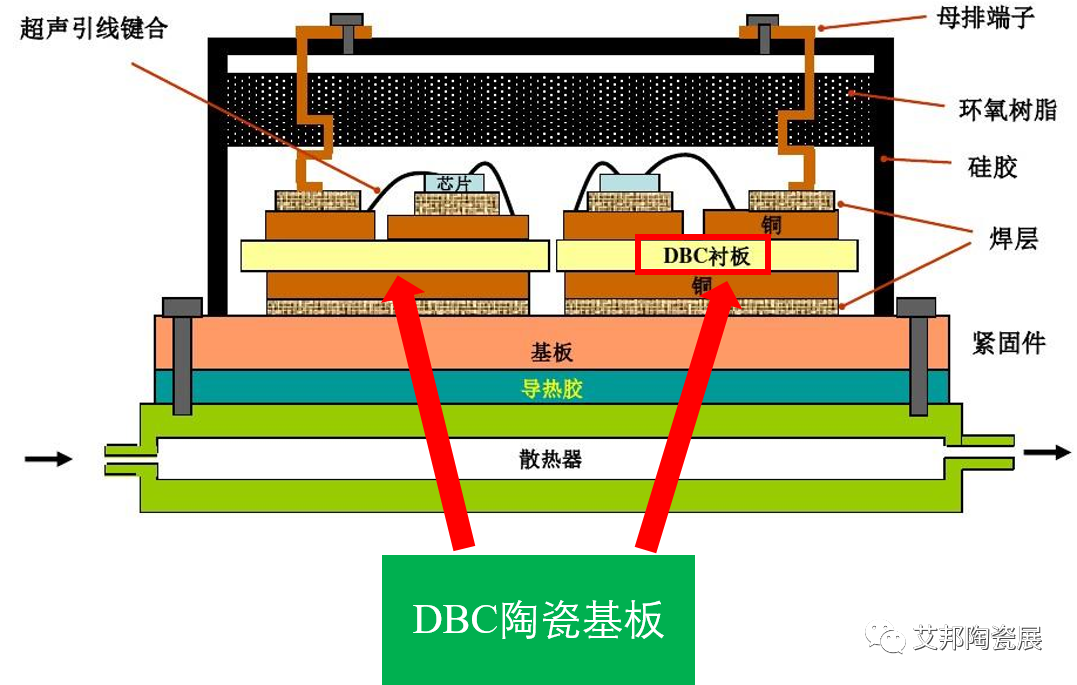
DBC在在含氧的氮气中以1063℃左右的高温加热,氮化铝陶瓷表面直接焊接上一层铜箔。但由于氮化铝是一种非氧化物陶瓷,敷接铜箔的关键是使其表面形成氧化物过渡层,然后通过上述过渡层与Cu箔敷合实现AlN与Cu箔的敷合。

陶瓷与铜界面结合紧密,结构致密。陶瓷晶粒大约为1-5μm,与铜之间存在8-10微米的过渡层。该过渡层结构致密,晶粒约为3-5μm,但是晶粒间存在不连贯的微裂纹。陶瓷表面致密,没有气孔存在。表面颗粒凹凸不平,可能是拉开时裂纹沿晶界扩展,部分颗粒在铜上部分颗粒在陶瓷上导致。

活性焊铜工艺是DBC工艺技术的进一步发展,它是利用钎料中含有的少量活性元素与陶瓷反应生成能被液态钎料润湿的反应层,从而实现陶瓷与金属接合的一种方法。先将陶瓷表面印刷活性金属焊料而后与无氧铜装夹后在真空钎焊炉中高温焊接,覆接完毕基板采用类似于PCB板的湿法刻蚀工艺在表面制作电路,最后表面镀覆制备出性能可靠的产品。一般地,DBC在高温情况下通过氧化膜结合在一起,AMB是在真空和高温下进行活性焊接,让陶瓷和铜焊接在一起,那么它的温度循环能力是传统的5-6倍。
高压大功率IGBT模块技术门槛高,特别是要求封装材料散热性能更好、可靠性更高、载流量更大。在汽车电动化需求旺盛的推动下,作为电动化下核心受益品种,预计全球新能源汽车IGBT将在未来几年实现快速增长,2025年市场规模达到约50亿美元。作为IGBT封装的核心材料,氮化铝陶瓷覆铜板的市场需求同样将十分巨大。
原文始发于微信公众号(艾邦陶瓷展):站在IGBT风口上,氮化铝陶瓷封装覆铜板腾飞在即