陶瓷外壳的发展趋势是单芯片外壳的高性能化和多芯片外壳的高集成化,在亿万门级FPGA、高端CPU、系统级SiP封装等产品需求的驱动下,封装密度提升、小型化需求对陶瓷外壳布线提出了精细加工的要求,线宽/线距向小于50um/50um的方向发展,全自动标准化生产方式将外壳加工效率和产品品质提升到新的高度。


陶瓷外壳在高性能、多功能薄型化、轻量化、集成化等器件中的应用,对高导热率的AIN陶瓷、大于700MPa抗弯强度A12O3陶瓷、与PCB板热膨胀系数更匹配的高膨胀系数陶瓷、高速高频用低损耗陶瓷及铜基低方阻浆料等新型材料和新型外壳提出了更迫切的需求。
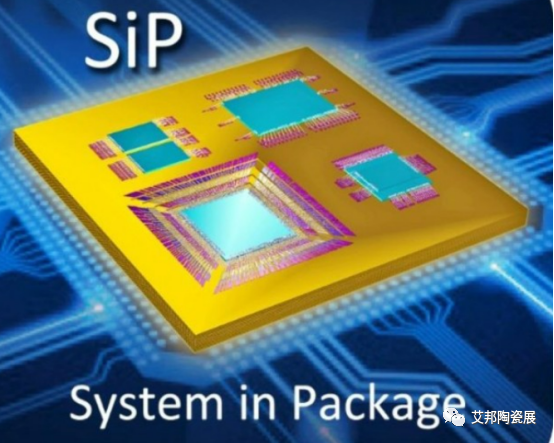
系统级封装(SiP)集成了引线键合、倒装焊和无源器件焊接等工艺,需要陶瓷外壳镀层同时满足引线键合和焊接要求合理布局、镀层优化调整是外壳单位设计制造高端产品的关键。Ni/Pd/Au镀层在同时满足引线键合和焊接需求上,有显著优势,是系统级封装外壳解决金属化镀层难题的关键。
以陶瓷为主体,在进行金属化之后,形成金属陶瓷外壳。金属陶瓷外壳作为集成电路的关键组件之一,起着电路支撑、电信号传输、散热、密封及化学防护等作用,在对电路的可靠性影响以及电路成本的占比方面,外壳均占有重要地位。
金属陶瓷封装技术向高密度、高性能、小型化模块化方向发展,系统级封装(SiP)以集成信号处理、存储、传输等功能的优势,是电子器件实现高性能、小型化的有效途径。随着封装密度提升带来的信号/申源完整性、散执、工艺兼容性、可制造性等问题,封装工艺板级组装应用与封装设计将更紧密的联合在一起,芯片、外壳、封装与应用的协同设计仿真将大大缩短产品开发周期。

以CQFN/CDFN、CSOP为代表的表贴类器件需求的增加,对窄间距装片、低弧度键合、窄边框封帽等小型化、精细封装工艺能力提出了新的要求:具有高导热系数的烧结银材料也将在金属陶瓷封装行业得到广泛应用。
由于集成电路的大规模增长需要,2022年陶瓷外壳需求将保持较大增速增长,陶瓷外壳、金属外壳封装业务也将持续增长。国内主要的陶瓷外壳生产企业有河北中瓷电子(003031)、潮州三环集团(300408)、合肥圣达、宜兴电子器件、嘉兴佳利电子、福建闽航、合肥伊丰、成都宏科、深圳瓷金、合肥中航天成等。
文章引用:杨兵,陈波.中国金属、陶瓷封装产业调研报告
原文始发于微信公众号(艾邦陶瓷展):金属陶瓷外壳发展趋势