陶瓷四边无引线CQFN(Ceramic Quad Flat Non-leaded Package)型陶瓷封装外壳产品与陶瓷无引线片式载体CLCC(Ceramic Leadless Chip Carriers)封装相似的CQFN型封装,由于其具有更优的电性能、更高的功率密度和封装密度、更高的可靠性,重量更轻,在高速、高频AD/DA、DDS等电路中,也被应用于声表面波器件、射频和微波等器件的封装。
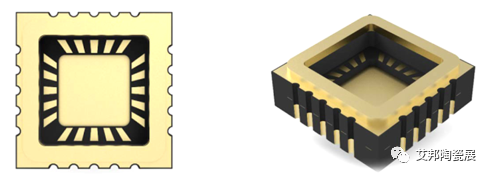
CQFN 图源自中航天成
CQFN陶瓷封装外壳产品具有体积小、导热性好、密封性好、机械强度高、封装可靠性高的特点。
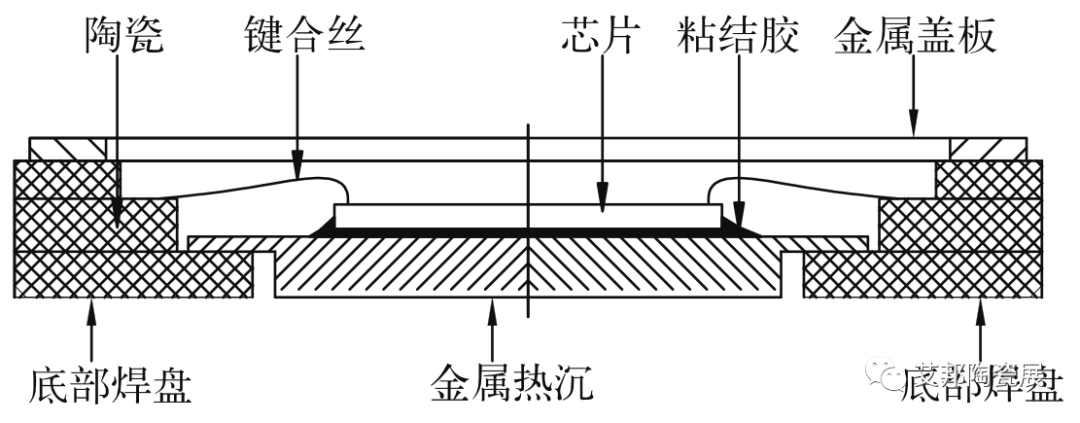
CQFN封装没有传统的引线结构,内部焊盘与外导电焊盘之间的导电路径短,自感系数和布线电阻很低,所以具有卓越的电性能。此外,热沉焊盘直接焊接在电路板上,有利于热量散发。由于体积小、重量轻、杰出的电性能和热性能,该封装特别适用于对尺寸、重量和性能都有要求的应用,所以非常适合应用在军用和高可靠领域中高频、高速LSI芯片封装中。
采用CQFN封装焊盘钎焊与电镀加工工艺表面贴装结构外壳,且钎焊、电镀简便,使陶瓷CQFN封装与塑料QFN封装可以完全兼容,实现了无铅封装,也适应有铅组装的高速集成电路封装。

由于塑封QFN产品在封装密性、内部热特性、贮存、应用等可靠性方面存在较大的缺陷,所以,有的器件需要用陶封产品替代,其缺陷主要表现在:
(1)封装气密性缺陷:塑封半导体器件容易吸入潮气;
(2)内部热特性受限:塑料、框架和芯片之间的热膨胀系数不同;
(3)应用受限:塑封产品为非气密性封装、导热性差使得其无法应用于大功率器件,在航空航天、空间应用等方面受到极大限制。
陶瓷外壳生产工艺包括有流延、冲孔、填孔、印刷、层压、热切、烧结、电镀等工序。其中CQFN产品涉及的关键工艺技术主要有:
(1)0.50mm姗小节距结构冲孔、注浆工艺技术;
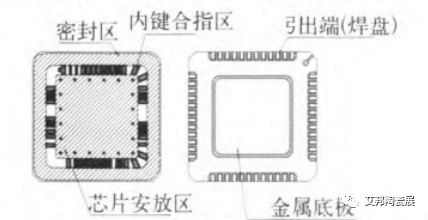
为了更好地解决表贴器件散热、焊料焊接检查、清洗难等难题,保证整机用户组装绝缘性能好,不产生短路失效,提升集成电路组装密度,产品设计创新是关键。CQFN的产品结构设计包括密封区、内键合指区、芯片安放区、金属底板、引出端5部分。
文章引用:蒋长顺.敖国军.张嘉欣.张顺亮.CQFN封装可靠性研究
余咏梅.小节距高可靠CQFTN型陶瓷封装外壳工艺技术
原文始发于微信公众号(艾邦陶瓷展):高可靠CQFN陶瓷封装外壳优势与应用一览