集成电路制造需要在单晶硅片上执行一系列的物理和化学操作,工艺复杂,在单晶硅片制造和前半制程工艺中会多次用到CMP技术。每一片晶圆在生产过程中都会经历几道甚至几十道的CMP抛光工艺。今天我们就来了解一下在这个关键工艺中塑料的应用,欢迎长按识别二维码,加入交流群。(https://www.ab-sm.com/)

化学机械平坦化(Chemical-Mechanical Planarization,CMP)又称化学机械研磨,是集成电路制造工艺过程中实现晶圆表面平坦化的关键技术。伴随着半导体制造工艺日益复杂,CMP的用处更加广泛。CMP保持环(CMP Retaining Ring)作为化学机械平坦化工艺的主要耗材之一,在CMP工艺中得到了广泛的应用。

图 半导体制程工艺流程,来源:西南证券
一、CMP保持环的作用
半导体技术不断发展,为增大芯片产量,降低生产成本,晶圆直径不断增大;同时,为提高集成电路的集成度,晶圆的刻线宽度越来越细,晶圆表面的精度也愈来愈高。晶圆直径增大后,加工中易出现翘曲变形,对于150mm直径以上的晶圆,容易在晶圆边缘形成"过磨"现象,降低抛光质量和晶圆利用率。在晶圆外添加一个保持环可以有效解决这一问题。
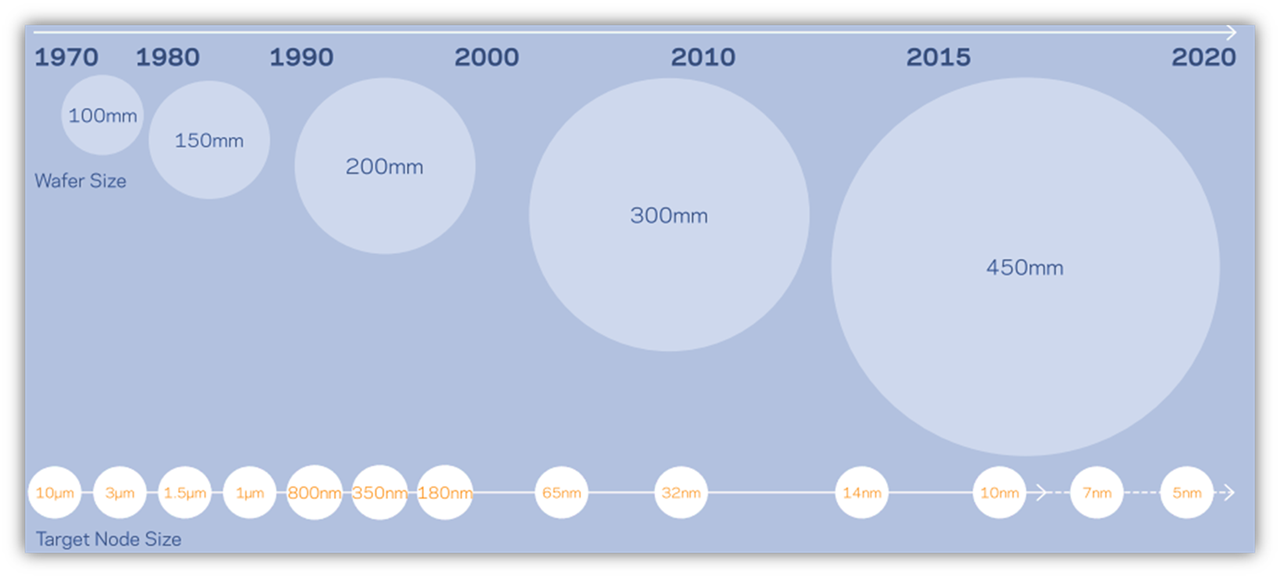 图 半导体技术发展,来源:科慕
图 半导体技术发展,来源:科慕
CMP保持环主要用于CMP抛光工艺过程中固定晶圆,把边缘的抛光垫和晶圆以下的抛光垫压平到同一高度,可有效解决"过磨"问题;此外,研磨液通过保持环接触面上的多个沟槽输送到抛光垫与晶圆之间的界面,提高晶圆去除率的不均匀性。

图 CMP机台构造,来源:Port Plastics

图 CMP 保持环,摄于威格斯展台
二、CMP保持环材质要求
如下图所示,在CMP工艺过程中,晶圆被固定在CMP保持环中,晶圆的下表面朝向研磨垫,抛光液经由CMP保持环流到抛光垫与晶圆之间的界面,当CMP保持环旋转时,晶圆也会被带动旋转,使得晶圆下表面相对抛光垫表面旋转而被研磨抛光。

图 晶圆CMP工艺示意图
在这个过程中,CMP保持环与晶圆一起被抛光,和抛光液以及抛光垫接触,CMP保持环应具有高耐磨、耐腐蚀、低振动特性、性能稳定性以及高纯净度等。因此对于材料要求有:
1、高耐磨耐蚀性
抛光液一般为微小颗粒的研磨材料和化学添加剂的混合物,研磨过程中会对CMP保持环造成磨损、刮擦、腐蚀。
2、良好的机械性能
CMP保持环需承受机械负载,应具有良好的弹性、韧性、强度。
3、高加工精度及尺寸稳定性
尺寸变化会增加发尘量,影响晶圆表面精度。
4、高纯净度
保持环的材料应具有低渗气性能、低的颗粒释放性。
5、良好的静电耗散
6、良好的振动抗性
7、良好的加工性能等
三、CMP保持环材质选择
研究表明²,不同材质保持环的相对磨损率随 CMP 加工条件和浆料特性而变化。 因此保持环材质需要根据CMP制程工艺参数(如抛光压力)以及抛光液、抛光垫等具体情况以及生产成本来进行选择。
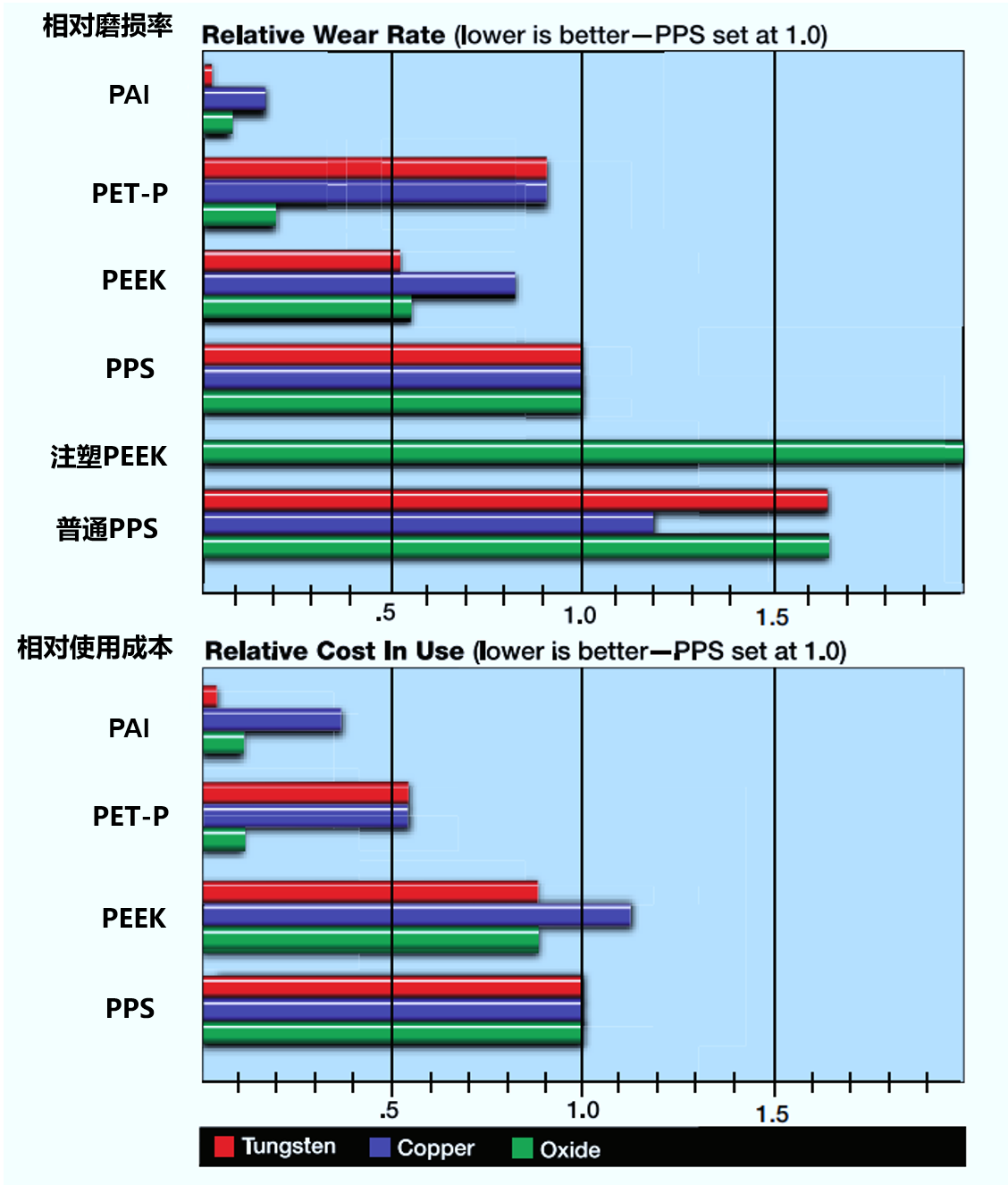
图 某品牌CMP保持环改性材料在钨抛光液(红色)、铜抛光液(蓝色)、氧化物抛光液(绿色)中的相对磨损率和使用成本比较
CMP保持环材质的选择影响 CMP 工艺的成本,包括保持环寿命以及保持环的磨损、振动或表面粗糙度等。CMP保持环对于材料的性能要求很高,所选用的材料有PPS、PEEK、PET-P、PAI等,这些材料一般经过改性处理,性能更加优越。
1、PPS
CMP保持环通常使用标准型特种工程塑料PPS制作。PPS具有耐高温、高机械强度、刚度、耐磨性,抗蠕变性能,尺寸稳定,优越的耐化学性和抗水解性等。经过改性后,性能有所提升,更能满足CMP工艺的要求。
相关材料企业有:三菱化学高新材料、恩欣格等。
2、PEEK
碳纤维增强PEEK复合材料是公认的目前制备CMP保持环的理想材料。PEEK材料具有优异的耐擦耐磨损性、耐化学性、机械强度、耐高温等特性,能够满足保持环的各项性能要求,在氧化物和钨抛光液中使用寿命更长,且比常用的PPS保持环耐磨损寿命提高2倍以上。
PEEK材料相关企业有威格斯、三菱化学高新材料、赢创、索尔维、鹏孚隆、恩欣格、君华特塑等。
3、PET-P
CMP保持环用的PET为半结晶性聚对苯二甲酸乙二醇酯材料,被称为PET-P塑料,具有优异的机械强度,良好的抗蠕变性能、良好的滑动和摩擦性能、耐磨损、尺寸稳定、耐化学药品性等特性。PET-P在氧化物抛光液中拥有较长使用寿命,5倍于 PPS,且成本较低。
相关材料企业有:三菱化学高新材料、恩欣格等。
4、PAI
聚酰胺酰亚胺(PAI)可用作CMP保持环,PAI是一种非结晶的耐高温工程热塑性树脂,具有诸多优异的性能,包括高强度、刚度,耐磨损,耐蠕变、耐高温,良好的耐化性等。PAI的耐磨损性和成本相对来说最好,但PAI材料存在吸湿性较高,可能会导致尺寸变化,且对接触饱和蒸汽敏感等。
相关材料企业有:三菱化学高新材料、索尔维、东丽、恩欣格等。
参考资料:
1.《化学机械抛光保持环工艺参数及磨损模型的研究》,西北工业大学,黄杏利
2.《CMP TRIBOLOGICAL STUDY OF CARRIER RING PLASTIC MATERIALS》,W.G.Easter,G. D. Willis,etc.


