大家好,欢迎回来。之前我们谈到了2.5D封装和TSV。今天我们来谈谈TSV。
什么是TSV?TSV是硅通孔的简写,利用通孔进行垂直的电连接,贯穿WAFER或芯片。一般来讲这种技术被一些类似台积电,联电和格芯等全球代工厂代工厂制造的。TSV可以替代引线键合和倒装焊技术。
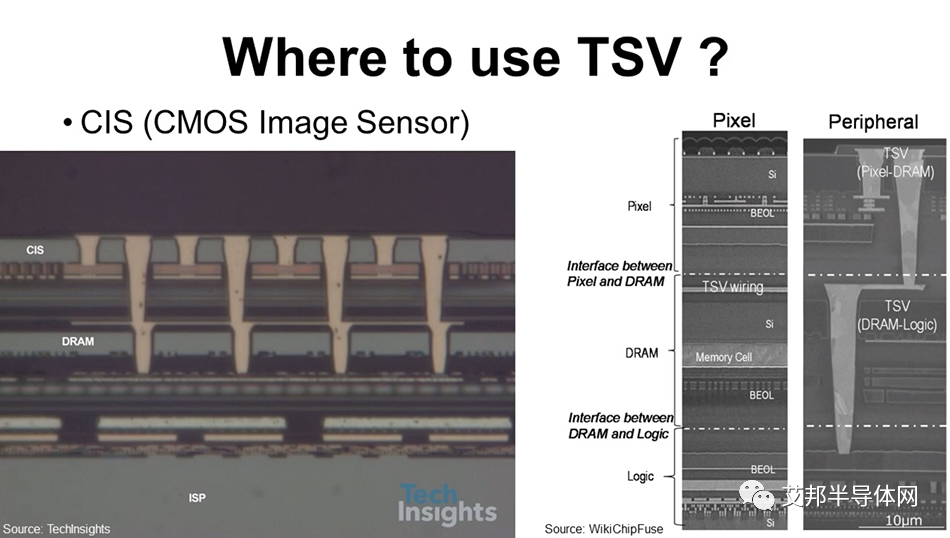
TSV用于2.5 d和3 d封装,用于电连接。根据TSV被制作的时间顺序有3种类型的TSV,分别指在晶圆制作工艺中的前,中或后段。第一个在晶圆制作工艺前段,意味着TSV在FEOL段前加工而成。因此工艺流程为:TSV刻蚀->TSV填充->FEOL->BEOL->Thinning+后道晶圆切割处理。第二种是在晶圆加工的中段生成TSV,工艺流程为:FEOL-> TSV刻蚀->TSV填充->BEOL->Thinning+后道晶圆切割处理。第二种在晶圆加工的中段生成TSV是当前最普遍采用的方法。最后一种方法简而言之就是在晶圆加工中的后段生成TSV。工艺流程为:FEOL ->BEOL->Thinning-> TSV刻蚀->TSV填充+后道晶圆切割处理。
现在根据这个图可以互相比较三者之间的区别。既然我么已经有了引线键合和倒装焊技术那么为什么我们还需要TSV?之前的那些技术不足以满足行业需求吗?
是的,TSV可以在没有引线键合情况下制作更薄的封装,因为引线键合在Z方向上是需要一定的空间的。倒装焊没有引线,但是不能将多个芯粒进行堆叠。而TSV可以做到即薄又可以堆叠多个芯粒。TSV还具有更短的电传导通路和更小的信号延迟。因此TSV的功耗比传统的引线键合及倒装焊要小,互连密度更高。这意味着它可以处理更多数据。
现在让我们讲讲如何制作TSV。核心关键步骤从通孔的形成开始,然后沉积绝缘层或阻挡层,接着生成铜晶种沉积,最后进行电镀。蚀刻工艺用于制作TSV被称作DEEP RIE也叫深度反应离子刻蚀,也被称为博世工艺,因为它是由德国公司罗伯特博世制造的。博世工艺的第一步是PR Patterning形成图案,这一步定义我们想要刻蚀的区域。第二步是各向同性蚀刻,在这个过程中,使用六氟化硫气体,它腐蚀硅衬底以制造TSV。第三步是钝化,在该工艺中,使用八氟环丁烷并制作钝化层以保护硅衬底免受蚀刻。第四步是钝化蚀刻,在此过程中等离子体仅刻蚀底部区域。第五步与第二步一样是各向同性蚀刻,但不同的是,此时有钝化层保护所以只蚀刻底部区域,最终制备出通孔。实际上,整个过程是不断重复步骤2,3和4。
制备好TSV后,它看起来像这样。首先有二氧化硅制备的绝缘层。然后由氮化硅、氮化钽或其它物质组成的是阻障层。接着是铜晶种层,最后由铜填充。这是最常见的结构。但有的TSV没有铜填充,只是保持孔洞。
现在我们有另一个问题。就是应用,TSV广泛用于图像传感器。这张照片是索尼3个晶粒形成的图像传感器。通过使用TSV技术,它可以以更快的速度生成更多的数据,从而制作高质量的视频。
下一个是存储。特别是HBM高带宽存储器。这是一个2.5d封装的存储器。在2.5d封装同时使用带有TSV技术的interposer。另一个是mems,最后一个是逻辑芯片,但它当前还不够流行,因为它很难制作。这就是对TSV技术的简要介绍。希望这可以帮助您了解基本的TSV技术。
原文始发于微信公众号(艾邦半导体网):先进封装TSV硅通孔技术介绍