
基板是裸芯片封装中热传导的关键环节。随着微电子技术的发展,高密度组装、小型化特性愈发明显,组件热流密度越来越大,对新型基板材料的要求越来越高,要求具有更高的热导率、更匹配的热膨胀系数以及更好的稳定性。目前,各种新型封装基板材料已成为各大厂竞相研发的热点,其中金刚石作为新一代基板材料正得到愈来愈多的关注。
封装基板材料的要求是:高电阻率、高热导率、低介电常数、介电损耗、与硅和砷化镓有良好的热匹配性、表面平整度高、有良好的机械性能及易于产业化生产等。早在1929年德国西门子公司成功研制Al2O3陶瓷后,已成为目前产量最多,应用最广的陶瓷基片,但由于其热膨胀系数 (7.2×10-6/℃) 和介电常数 (9.7) 相对Si单晶而言偏高, 热导率 (15-35W/ (m·K) , 96瓷) 仍然不够高, 导致Al2O3陶瓷基片并不适合在高频、大功率、超大规模集成电路中使用。因此, 开发高热导率、性能更为完善的基片材料成为大势所趋。随之高导热陶瓷基片材料AlN、SI3N4、SiC、金刚石逐步进入市场之中。

SiC陶瓷的热导率很高,且SiC结晶的纯度越高, 热导率越大;SiC最大的缺点就是介电常数太高, 而且介电强度低, 从而限制了它的高频应用, 只适于低密度封装。AlN材料介电性能优良、化学性能稳定, 尤其是它的热膨胀系数与硅较匹配等特点使其能够作为很有发展前景的半导体封装基板材料, 但热导率目前最高也只能260W/ (m·K),随着半导体封装对散热的要求越来越高,AlN材料也有一定的发展瓶颈。
金刚石是目前已知自然界中热导率最高的物质,单晶金刚石的热导率为2200~2600 W/(m.K),热膨胀系数约为1.1×10-6/℃ ,在半导体、光学等方面具有很多优良特性,虽然单一的金刚石不易制作成封装材料,且成本较高,但其优胜于其他陶瓷基板材料数十倍甚至上百倍的热导率,也让许多大厂纷纷投入研究,其中斯利通半导体封装基板厂就出厂过一款产品。
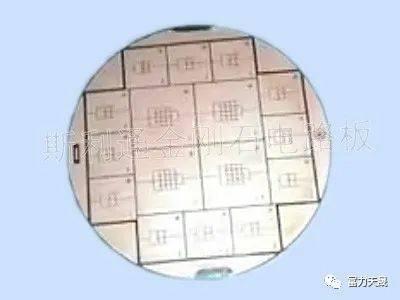
此金刚石封装基板是应用于高压大功率电力电子器件中,斯利通半导体封装基板厂研发过程中先将金刚石表面清洗干净后烘干,再在其表面先用磁控溅射镀膜一层金属钛,再镀膜一层金属铜,保证金刚石基板与金属的结合力。然后经过线路曝光、显影、电镀、蚀刻,形成电路图形,其中还要克服了加工过程中金刚石高硬度的负面影响,保障金刚石封装基板的性能。
金刚石是一种热导率很高,散热性非常好的基板材料,在较高温度环境下应用前景广阔,是制造低功耗、高功率密度器件的最佳半导体材料,其巨大的潜力吸引着越来越多的研究者投身其中。
未来随着材料、器件等各方面问题的不断解决,金刚石的潜力将逐渐得到开发,满足未来半导体行业的需求,并在半导体封装材料中占据一席之地。
参考文献:张梁娟 钱吉裕 孔祥举 韩宗杰 基于裸芯片封装的金刚石/铜复合材料基板性能研究
卢振亚 陈志武 电子封装用陶瓷基板材料的研究进展
原文始发于微信公众号(富力天晟):超高热导半导体封装基板——金刚石
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入交流群。



