随着5G的发展,高速处理大容量数据的需求不断增加,高性能计算机群(High Performance Computing,简称HPC)作为高性能数据处理的解决方案,被各个领域的公司和组织使用。
现在,高性能计算机群(HPC)器件的基板材料主要使用有机材料,但随着IC芯片・Si转接板的大型化的推进,为了确保一次封装※1时以及一次封装后的可靠性,缩小与基板材料的热膨胀系数差异变得非常关键。
京瓷开发的低热膨胀陶瓷基板材料GL570,热膨胀系数与Si接近,同时又具有高刚性,是适用于高性能计算机群(HPC)中大型化IC芯片或Si转接板的一次封装,且能确保可靠性的材料。
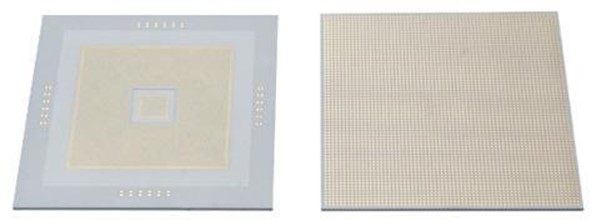
京瓷制GL570基板
高速处理大容量数据的高性能计算机群(HPC)器件,需要搭载多个高性能且低功耗的IC芯片。业界正在开发Chiplet技术※2和2.5D封装技术※3,利用这些技术生产高性能计算机群(HPC)器件,以满足市场需求。而为了实现多个IC芯片的高度集成,会考虑采用大型Si转接板的解决方案。
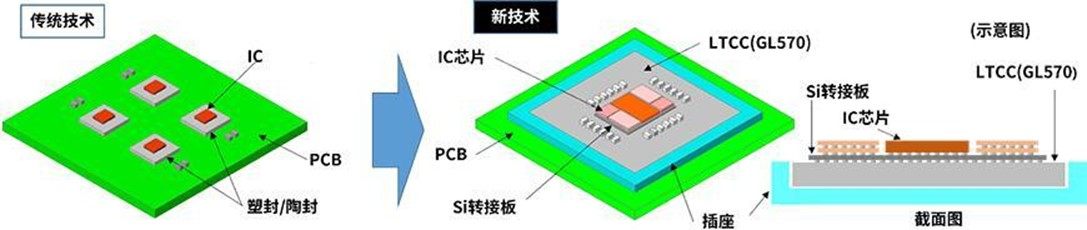
京瓷的低热膨胀陶瓷基板材料GL570,采用热膨胀系数和Si相近的材料,实现了低热膨胀,高刚性,因此非常适用于对应不断推进大型化的Si转接板。

高刚性的陶瓷基板可以缓解一次封装时的热应力,同时抑制IC芯片・Si转接板的形变。除此之外,结合GL570的另一个特征----低热膨胀系数,可以实现更高水准的一次封装可靠性。

京瓷还可以根据客户需求提供大型基板定制,大型单晶芯片和Si转接板以及周围零部件可一次性全部装配在基板上。

※1 一次封装
IC芯片或Si转接板封装到基板上
※2 Chiplet技术
根据不同功能使用不同process node生产IC芯片并进行集成化的技术。对于各个功能采用最合适的process node,可以降低IC芯片的生产成本。
※3 2.5D封装技术
多个IC芯片装载在单一Si转接板上,在Si转接板内进行电气布线的技术。可实现Chiplet间的布线长缩短,IC芯片间延迟改善,以及模块的低功耗化。
来源:京瓷
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入交流群。



