电子封装材料一般要具备与芯片相匹配的热膨胀系数,同时具有很好的散热性能。而广义的电子封装材料指除芯片以外,封装体中剩下的所有部分,包括封装外壳、基板、键合线、粘结材料、引线框架、封装体底部焊点、散热片等。
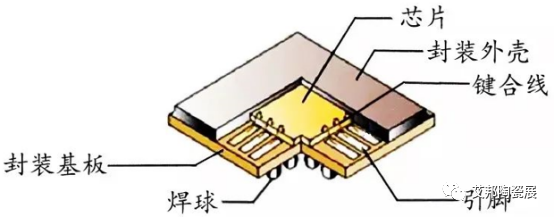

陶瓷封装外壳主要对芯片和引线框架起到密封和保护的作用,通常需要具有与芯片相匹配的热膨胀系数,散热性较好且与内部器件的黏结性较好。目前而言,在导热和可靠性要求较高的场合,会采用陶瓷封装,比如一些军用模块、激光雷达、通讯器件等会使用陶瓷封装。
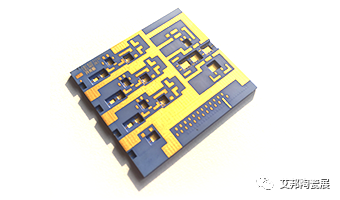
基板主要对芯片起到固定、支撑、散热以及连接下层电路板的作用,在很多封装形式当中可能不涉及基板,而是芯片直接贴装在引线框架上。基板通常可以分为树脂基板、陶瓷基板、金属基板。常见的树脂基板有玻璃纤维增强环氧树脂基板、BT树脂基板,常见的陶瓷基板为高温共烧陶瓷基板(HTCC)和低温共烧陶瓷基板(LTCC),金属基板有铜基板、铝基板。

引线框架的主要作用是承托芯片和外引管脚。一般需要具备高导电、导热性,良好的热匹配,良好的耐蚀性和抗氧化性。引线框架采用的材料一般为铜合金或铁镍合金。对于小尺寸芯片,引线框架一般采用综合性能较好的铜合金(包括铜-铁系,铜-镍-硅系,铜-铬系,铜-镍-锡系),而一般的芯片则采用铁镍合金作为引线框架,其表面镀铜。4、键合线

常用的键合线为金线、铜线或铝线。键合线常用来连接芯片焊点和引线框架或基板,以实现芯片和外电路的电气连接。键合线一般应具备良好的导电、导热性,且与芯片之间焊接性良好。

粘结材料是将芯片与承载体连接的材料,以起到固定芯片的作用(因为处于芯片和基板之间,未在图1中显示出来)。一般应具有物理、化学性能稳定,导电导热性强,低固化温度等要求。根据贴装方式的不同,常用的粘结材料有银浆、低熔点玻璃、导电胶、环氧树脂、金属-硅共晶体。

焊点指的是封装体底部与电路板连接时的焊球以及焊球与封装体连接使用的共晶焊料。通常陶瓷球栅阵列封装(CBGA)会采用底部焊点与电路板相连,其焊球材料为高温共晶焊料10Sn90Pb,焊球和封装体的连接采用低温共晶焊料63Sn37Pb。
由于芯片封装的形式多样,涉及的材料种类也比较多,不同的封装类型涉及的相关材料也不太一样,这里只是列举出常见的一些在陶瓷封装中需要应用到的材料。
原文始发于微信公众号(艾邦加工展):一文看懂陶瓷封装所需材料